DBI Ultra는 CPU, GPU, FPGA 또는 SoC와 메모리를 통합해야 하는 2.5D 및 3D 응용 프로그램뿐만 아니라 3D 스택 메모리에서도 성공을 실현한다. 스마트폰과 스마트 홈에서부터 인공지능과 빅데이터에 이르기까지 다양한 애플리케이션에 대한 솔루션을 제공할 수 있다.
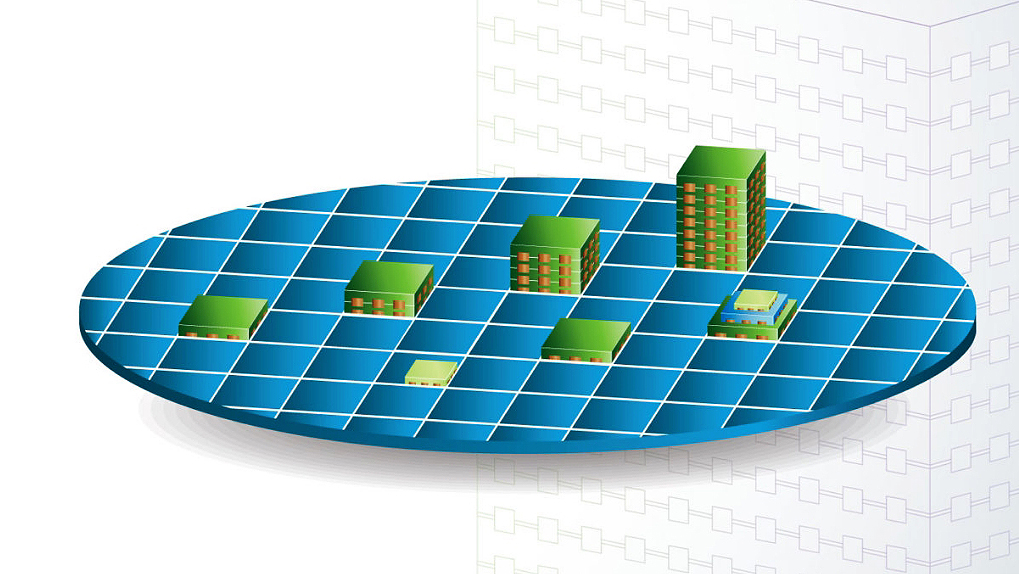
DBI Ultra는 CPU, GPU, FPGA 또는 SoC와 메모리를 통합해야 하는 2.5D 및 3D 응용 프로그램뿐만 아니라 3D 스택 메모리에서도 성공을 실현한다. 스마트폰과 스마트 홈에서부터 인공지능(AI)과 빅데이터에 이르기까지 다양한 애플리케이션에 대한 솔루션을 제공할 수 있다.
현지시간 6일, 엑스페리(Xperi Corporation)가 SK 하이닉스와 차세대 메모리 반도체를 위한 DBI(Direct Bond Interconnect) Ultra의 기술 이전 포함하는 새로운 특허 및 기술 라이센스 계약을 체결했다고 밝혔다.
계약 세부 조건은 밝히지 않았지만 이 협약에는 엑스페리의 광범위한 반도체 지적재산 포트폴리오(IP)에 대한 접근과 차세대 메모리에 초점을 맞춘 자회사인 인벤사스(Invensas) DBI Ultra 3D 상호연결 기술의 이전 등이 포함된다.
인벤사스(Invensas Corp) 크레이그 미첼(Craig Mitchell) 사장은 "세계적으로 유명한 기술 리더이자 메모리 솔루션 제조업체인 SK하이닉스와의 오랜 관계 연장을 발표하게 되어 기쁘다"고 말했다.
또 그는 "인벤사스는 업계에서 기존의 노드 확장을 넘어 하이브리드 본딩으로 눈을 돌리면서 성능, 전력, 기능성을 지속적으로 향상시키는 동시에 반도체 비용도 절감하는 선구자적 리더로 우뚝 섰다"며, 이번 SK하이닉스와의 제휴를 통해 DBI 울트라 기술을 더욱 개발하고 상용화하게 된 것을 자랑스럽게 생각하며, 이 혁신적인 기술 플랫폼의 장점을 활용한 폭넓은 메모리 솔루션을 기대한다고 말했다.
DBI Ultra는 동종 및 이종 3D 통합의 새로운 시대를 여는 특허받은 Die-to-Wafer 하이브리드 결합 3D 인터커넥트 기술 플랫폼이다.
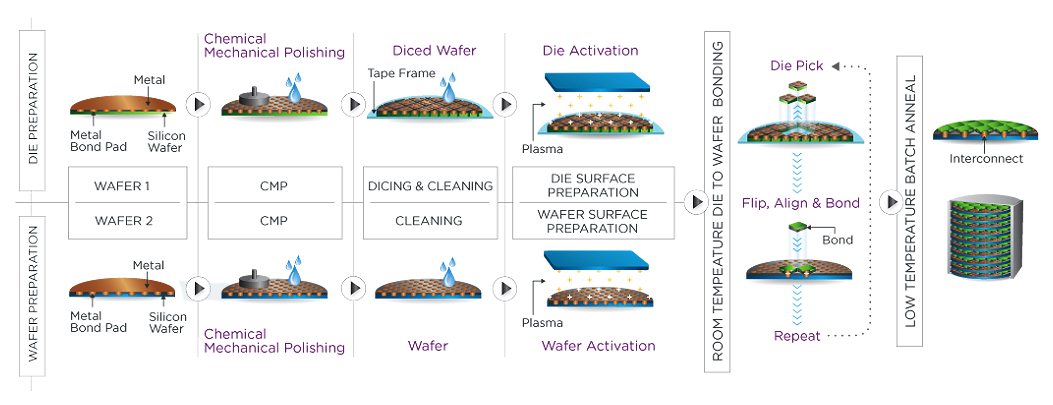
그것은 반도체 업계가 무어의 법칙을 넘어서는 범위를 넓힐 수 있게 해 전례 없는 2.5D와 3D 통합 유연성을 제공한다. 다양한 애플리케이션 중에서 DBI Ultra는 8개, 12개, 심지어 16개의 하이 칩 스택을 제조할 수 있도록 하는 동시에 차세대 고성능 컴퓨팅의 까다로운 성능 요구사항을 충족시킨다.
DBI Ultra의 전신인 DBI 웨이퍼 대 웨이퍼 하이브리드 본딩은 이미 전 세계 수억 개의 스마트폰으로 전송되는 이미지 센서와 RF 구성 요소에 성공적으로 통합되어 있다.
한편, 엑스페리는 인벤사스 DBI Ultra는 CPU, GPU, FPGA 또는 SoC와 메모리를 통합해야하는 2.5D 및 3D 응용 프로그램뿐만 아니라 3D 스택 메모리에서도 유사한 성공을 실현한다. SK 하이닉스 같은 업계의 리더가 최적화하고 적용하면 이러한 기술과 그에 따른 반도체 제품은 스마트폰과 스마트 홈에서부터 인공지능(AI)과 빅데이터에 이르기까지 다양한 애플리케이션에 대한 솔루션을 제공할 수 있다고 밝혔다.

